台積電在其北美技術研討會上推出了一項新技術,將晶圓處理器的制造帶入了第三維度。這一技術名爲CoW-SoW,該平台將晶圓級設計與3D集成相結合。CoW-SoW基于台積電于2020年推出的InFO_SoW晶圓上系統集成技術,該技術已被廣泛應用于晶圓級邏輯處理器的制造,特斯拉的Dojo超級計算機便是其生産的案例。
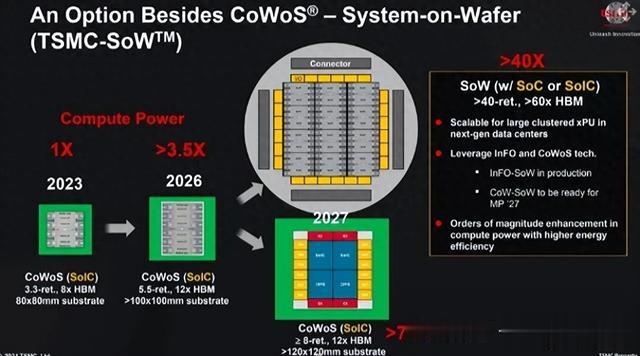
在即將推出的CoW-SoW平台中,台積電將其兩種封裝方法——InFO_SoW和系統集成芯片(SoIC)——融合到晶圓系統平台中。通過使用晶片芯片(CoW)技術,該方法可以直接將內存或邏輯堆疊在晶片系統上。預計新的CoW-SoW技術將于2027年投入大規模生産,但實際産品的上市時間仍需觀察。
台積電業務發展副總裁Kevin Zhang表示:“未來,利用晶圓級集成將使客戶能夠在一起集成更多的邏輯和內存。我們已經與客戶合作生産了一些産品,因此我們認爲通過利用先進的晶圓級集成技術,我們可以爲客戶提供一個非常重要的途徑,使他們能夠繼續擴展其能力,爲其人工智能集群或超級計算機提供更多計算,更節能的計算。”
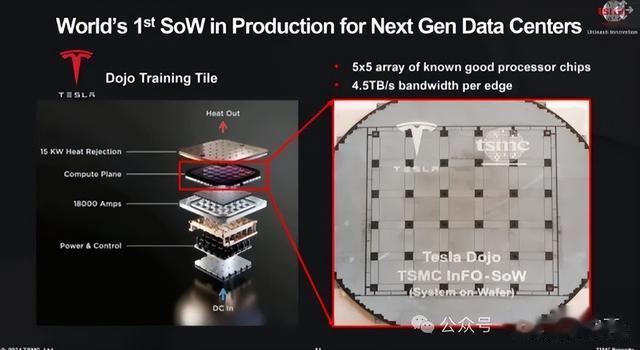
當前,台積電的CoW-SoW專注于將晶圓級處理器與HBM4內存集成。這些下一代內存堆棧將采用2048位接口,這將使HBM4直接集成在邏輯芯片上成爲可能。同時,在晶圓級處理器上堆疊額外的邏輯以優化成本也是有意義的。
晶圓級處理器提供了顯著的性能和效率優勢,包括高帶寬和低延遲的核心對核心通信、低功耗傳輸網絡阻抗和高能效。然而,InFO_SoW技術也存在一定局限性,如完全依賴芯片上內存、不支持3D堆疊等。CoW-SoW技術的推出將有望解決這些問題,爲晶圓級處理器的發展帶來新的機遇。
歡迎關注芯片行業動態!
